半导体元件的封接或封装方式分为气密性封装和树脂封装两大类,气密性封装又可分为金属封装、陶瓷封装和玻璃封装。封接和封装的目的是与外部温度、湿度、气氛等环境隔绝,除了起保护和电气绝缘作用外,同时还起向外散热及应力缓和作用。
一般来说,气密性封装可靠性高,但价格也高。目前由于封装技术及材料的改进,树脂封装已占绝对优势,但在有些特殊领域(军工、航空、航天、航海等),气密性封装是必不可少的。
按封装材料可划分为:金属封装、陶瓷封装(C)、塑料封装(P)。采用前两种封装的半导体产品主要用于航天、航空及军事领域,而塑料封装的半导体产品在民用领域得到了广泛的应用。
目前树脂封装已占世界集成电路封装市场的98%,97%以上的半导体器件的封装都采用树脂封装,在消费类电路和器件领域基本上是树脂封装一统天下,而90%以上的塑封料是环氧树脂塑封料和环氧液体灌封料。
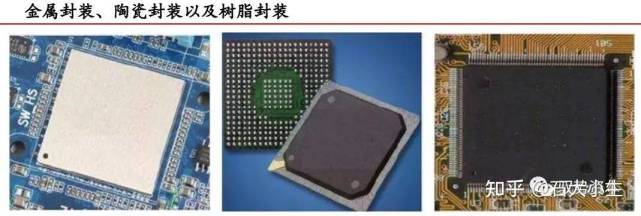
COPYRIGHT © shuangsai.net ALL RIGHTS RESERVED. 惠州双赛电子科技有限公司 版权所有
粤ICP备2022123491号